掃描電容顯微鏡(SCM)是一種表征材料納米電學性質的先進成像技術,學術界和工業界的研究人員均可憑借這一技術測量離子注入工藝過程中極小的波動和偏差,同時也可以研究材料的摻雜水平,從而進行失效分析。
牛津儀器于近期推出的搭載于Cypher和Jupiter型號AFM上的SCM模塊除了可以輕松實現以上工作外,還具有明顯優于傳統SCM的巨大技術優勢,包括更高的靈敏度、更高的分辨率、更快的成像速度以及可以直接準確測量電容的能力,而不是僅僅對于微分電容(dC/dV)進行分析。
本文將從以下角度介紹這一模塊:
SCM的工作原理
牛津儀器的SCM模塊如何實現如此好的性能
為什么SCM直接測量電容的能力比傳統的對微分電容(dC/dV)進行測量更加實用
傳統半導體器件的成像實例
在此之前通過普通SCM技術不能實現成像的材料研究實例,包括不形成自然氧化層的材料
本文對于如下人員尤為具有實用意義:
半導體工業界的工藝工程師和失效分析工程師
微電子設備和下一代半導體材料的研發人員
研究其他先進材料的科研人員,包括二維材料和儲能材料
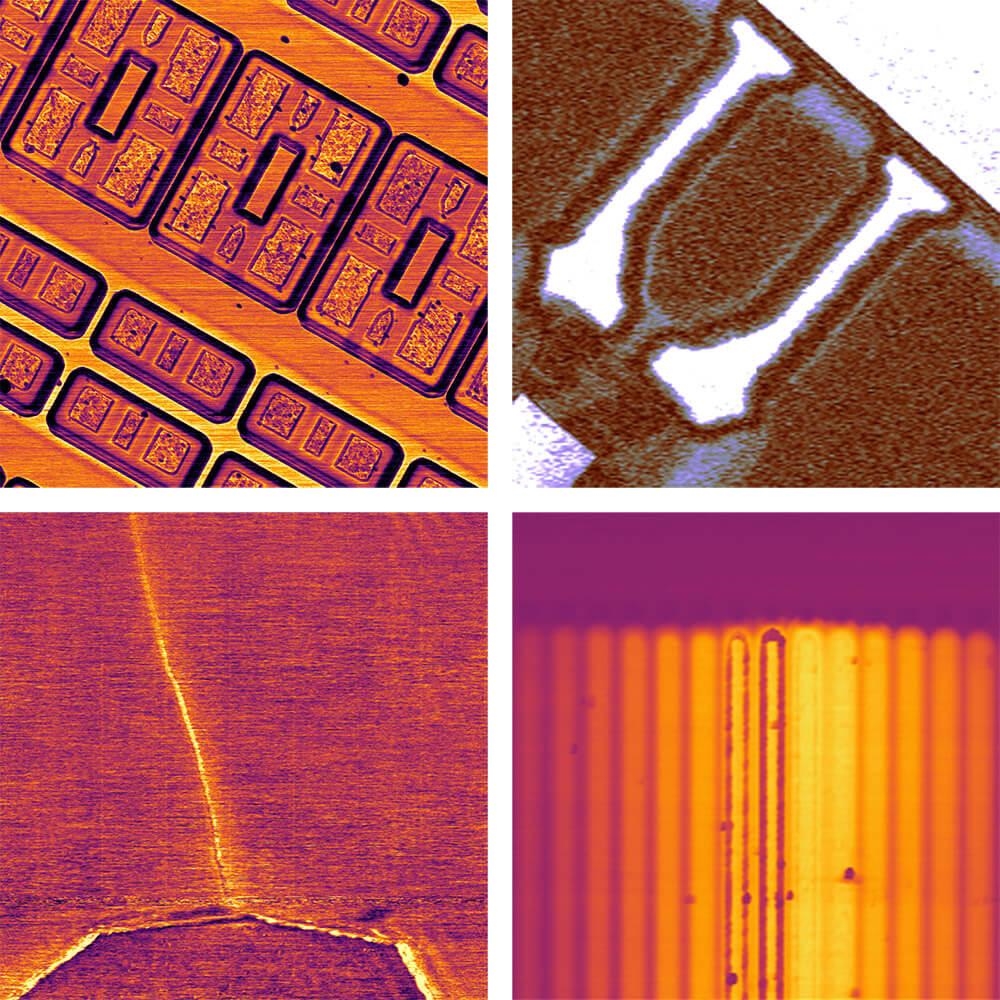
(左上)牛津儀器的SCM模塊可以直接測量樣品的電容,而不僅是微分電容(dC/dV)。所示樣品為通常用于SCM模塊標樣的SRAM樣品。
(右上)牛津儀器的SCM模塊具有優于其他SCM的更快的掃描速度。此處掃描速度為8Hz,是傳統SCM的8-16倍
(右下)所用樣品為階梯摻雜標樣。和dC/dV amplitude的數據相比,電容的數據與摻雜水平的線性相關性更強。
(左下)牛津儀器的SCM模塊具有比傳統SCM更高的靈敏度,可以對一些非傳統半導體材料進行表征,圖示樣品為碳納米管
 儀表網手機版
儀表網手機版
 儀表網小程序
儀表網小程序
 公眾號:ybzhan
公眾號:ybzhan
 掃碼關注視頻號
掃碼關注視頻號